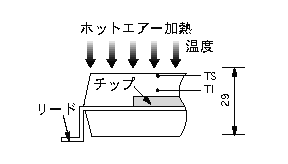
図 パッケージリフロー状況
電子機器が作動不良となった。調査の結果、半導体チップにクラックが発見された。この半導体パッケージは、図のように、基板にリフローはんだ付けで実装されている。この時は、ホットエアーの急激な加熱によって、パッケージ内に過渡的な温度差TS-TIが生じ、その結果、熱応力が発生するが、その熱応力がクラックの原因であった。なお、リフローはんだ付けとは、基板上にはんだ印刷を行い、部品を搭載したあとに加熱してはんだを溶かし、はんだ付けする実装方法である。
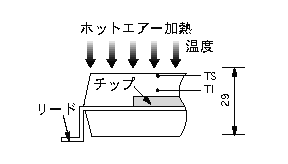
【設計のアドバイス】
電子機器の小形化や半導体自身の高機能化で、半導体素子のパッケージも小形化、薄膜化、多ピン化している。面実装形パッケージもその一つである。一般に、耐熱ストレス性や耐湿性が低下するので、基板への実装時には、パッケージやチップのクラックが発生しないように温度条件、特に加熱冷却速度を決定する。